パターニング加工(フォトリソグラフィ)
半導体ウェハーやサファイヤ、ガラス、石英などの基板上に、マスクに描かれたパターンを転写しパターン形成を行っています。
少量試作・開発・量産まで受託加工サービスをご提供いたします。
マスク設計も承っております。
レジスト塗布済みウエハーの販売も行っています。詳しくはお問い合わせください。
フォトリソ加工能力
|
装置 |
対応基板 |
仕様・特徴 |
|
NSR-i10C |
材質:シリコン、ガラス、セラミック、石英など |
最大shotサイズ:20mm×20mm |
|
MASK ALIGNER |
材質:シリコン、ガラス、セラミック、サファイヤ、 |
アライメント:通常の表面アライメントと裏面アライメント可能 |
パターニング加工例
お客様の様々なご要望にお応えし、高アスペクト比、薄物ウェハー等にも対応可能です。
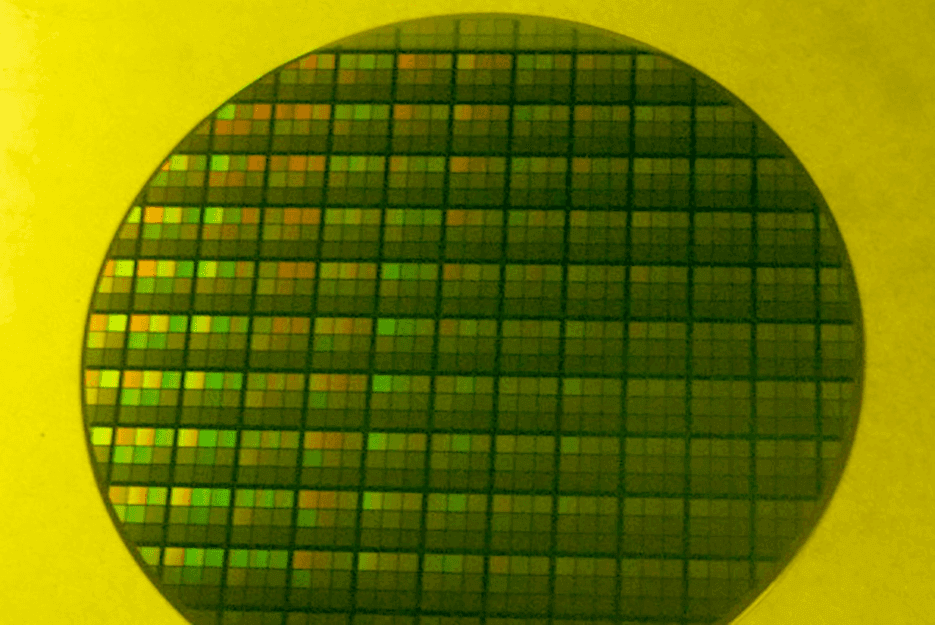 フォトリソ |
 フォトリソ |
 フォトリソ |
上記以外にも多くの加工事例を「ウェハー加工の事例集」ページでご覧いただけます。
|
工程 |
製法・装置 |
備考 |
対応基板サイズ |
|
前処理 |
HMDS処理 |
? |
Φ2″~Φ8″ |
|
パターニング |
全自動コーター・デベロッパー |
ポジレジスト、ネガレジスト |
Φ4″~Φ8″ |
|
マニュアルコーター |
? |
Φ2″~Φ8″ |
|
|
DFラミネーター |
幅285mm、厚み70umまで可能 |
Φ2″~Φ8″ |
|
|
ステッパー(i線) |
加工能力 0.4μm(実績)以上 |
Φ2″~Φ8″、Si、サファイア、ガラス(石英) |
|
|
マニュアル現像機 |
? |
Φ2″~Φ8″ |
※特記事項 (対応基板については、異形基板も検討可能)
全自動コーター・デベロッパー装置「Dual-1000T」
スピン塗布ユニット、スピン現像ユニット、ベークプレート、クーリングプレート、カセットステージ、自動搬送ロボット等を搭載し、自動でレジスト等の塗布、現像、ベークの処理が行える装置です。
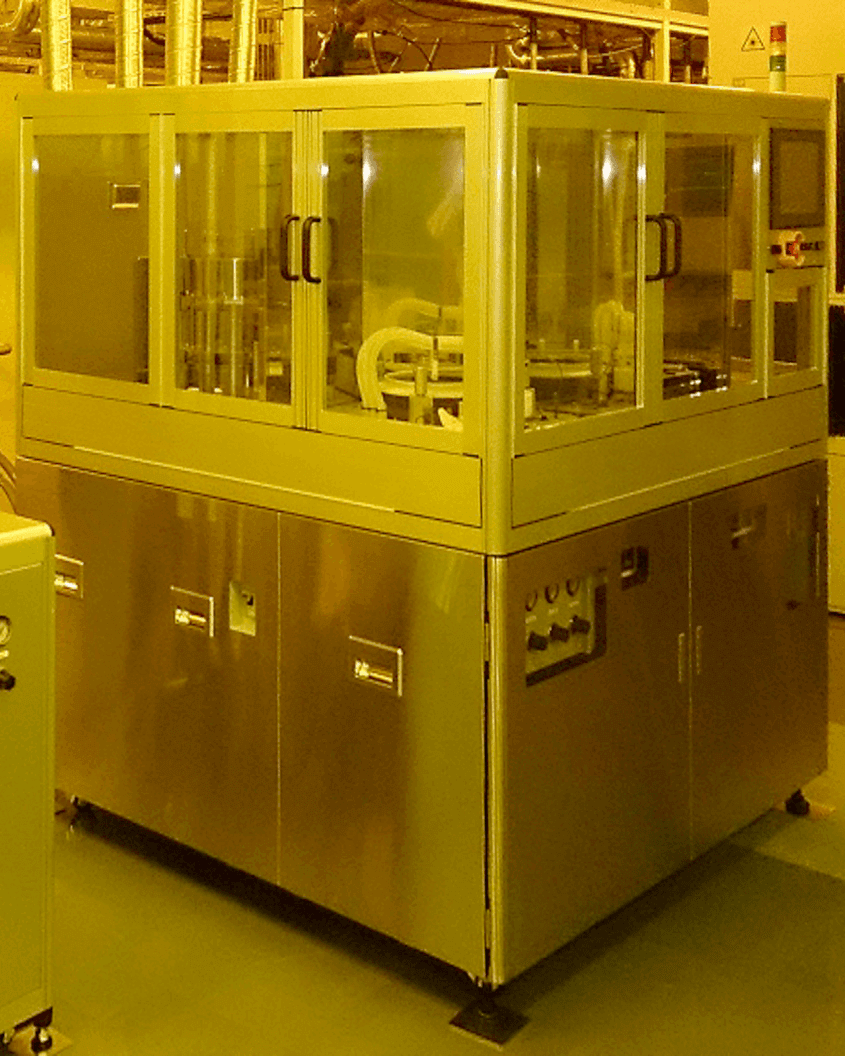
全自動コーター・デベロッパー装置「Dual-1000T」
|
スペック |
|
|
Dual-1000T |
・4~ 8インチのウェハサイズ対応 |
ステッパー(i線ステッパー)装置「NSR-i10C」
高精度、高解像にてパターニングが可能。オリフラタイプ、ノッチタイプ両方に対応可能。また、レチクル設計からジョブ作成まで一環して社内エンジニアが担当いたします。

ステッパー(i線ステッパー)装置「NSR-i10C」
|
スペック |
|
|
NSR-i10C |
・2~ 8インチのウェハサイズ対応 |
両面マスクアライナー装置「MASK ALIGNER BA200k」
試料の表面/裏面アライメントを、高解像度4視野カメラとモニタによる観察で行うことができます。
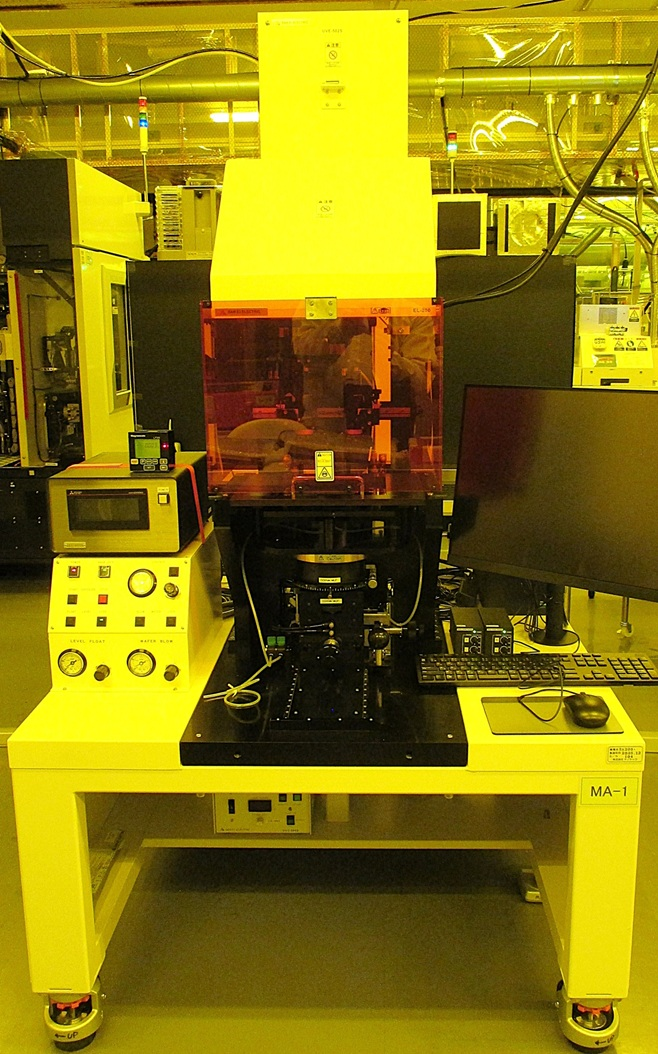
両面アライナー装置「MASK ALIGNER BA200k」
|
スペック |
|
|
MASK ALIGNER |
・基板材質 シリコン、ガラス、セラミック、サファイヤ、SiCなどの化合物、石英など |
フォトリソ
フォトリソ(フォトリソグラフィ)は、フォトレジスト(感光性)を塗布するコーティング、パターンが形成されたフォトマスクにUV光を通過させてウェハー上に光を当てる露光、露光された部分とされていない部分を現像液によってパターンを形成する現像をまとめた工程をフォトリソといいます。 フォトリソの目的は、形成したいパターンを紫外線などの光を照射することによってウェハー上に形成することです。(※銀塩写真を現像する工程と類似していることから、この様に呼ばれています。)
HMDS処理
HMDSとは、ウェハー加工の途中にレジストが剥がれないよう密着性を高める処理を指します。ウェハーの表面が親水性の場合、現像液がウェハー表面とレジストの間に混在し、レジストが剥離される可能性があります。 HMDS処理の役目は、その剥がれを防ぐ為にウェハー表面を疎水化する加工であり、レジストをコーティング(塗布)する前に行われます。
レジスト塗布
レジストはフォトリソ工程でパターニングする際に保護膜としての役割を持つ物質。スピンコーター装置でウェハーを高速回転させながらレジスト塗布(コーティング)を行い、レジストが全面的に均一になるようにレジスト膜を形成していきます。 半導体におけるフォトリソグラフィでは、フォトレジストと呼ばれ、感光性のレジストを使用して作業を行います。
露光
電子回路パターンが描写されたマスク(レチクル)にUV光を当ててウェハー上のレジスト膜に転写していく工程。プロジェクション露光においては、レンズなどの光学系を使用して投影させます。 プロジェクション露光は2種類に分類され、マスク上のパターンを一括で描写してウェハー上に投影させるアライナー(一括露光装置)と、水銀ランプから放出された光(i線やg線)が縮小投影レンズによりウェハー上をステップしながら投影露光されていくステッパー(分割露光装置)があります。 ステッパーは縮小投影での露光であるために、微細パターニングに優れています。
現像
上記の過程で、露光されたウェハーを現像装置(デベロッパー)にセットし、現像液を浸すことで感光部分を除去(ポジ型レジスト)、または未感光部分を除去(ネガ型レジスト)する工程。 現像の際に、実際に光が転写された露光部分が浮き彫りになってパターンが形成されます。








