パターニング加工(エッチング)
半導体ウェハーや石英などの基板上に形成された膜を化学反応で削り、数百ナノレベルのパターン形成を行っております。
少量試作・開発・量産まで受託加工サービスをご提供いたします。
エッチング加工能力
|
装置 |
加工能力 |
対応ウェハサイズ |
特徴・備考 |
|
RIE-10NR |
絶縁膜,シリコン系,SiO2,SiN,Si,Poly-Si
|
最大8インチまで対応,異形基板も対応可能
|
各種シリコン薄膜の高精度エッチング |
|
ウェット |
エッチャント:Cr,ITO,Cu,Ni等実績あり |
※各種ドライエッチング、ウェットエッチングに対応いたします。
※その他にもご希望に応じて対応できる場合もございますので、お気軽にご連絡下さい。
パターニング加工例
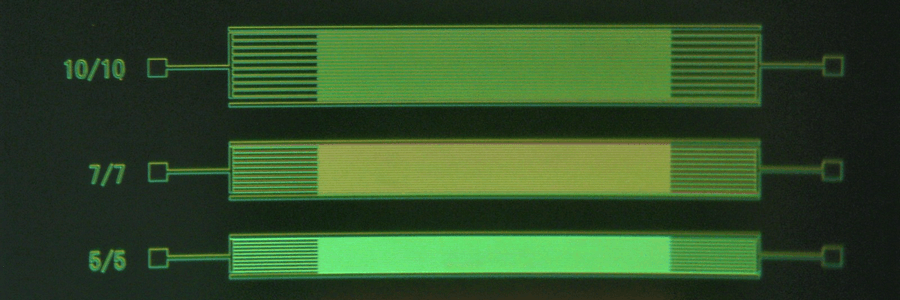 SiO2エッチング加工 |
 SiO2エッチング加工 |
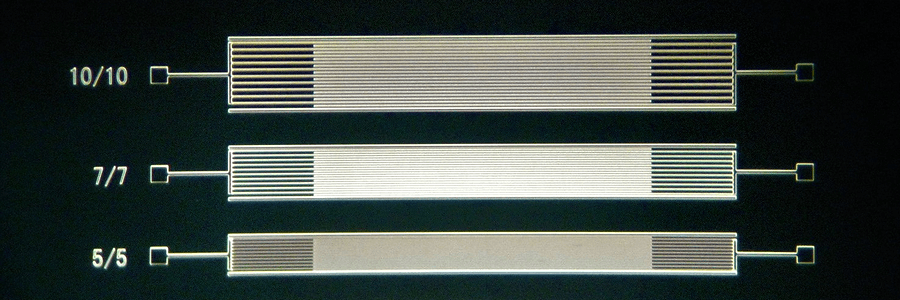 Siエッチング加工 |
 Siエッチング加工 |
上記以外にも多くの加工事例を「ウェハー加工の事例集」ページでご覧いただけます。
|
加工種類 |
製法・装置 |
備考 |
対応基板サイズ |
|
ドライエッチング |
ドライエッチャー(RIE) |
Si、Poly-Si、SiO2、SiN、SiON、石英(他は応相談) |
最大Φ8″まで対応可能(2,4,6インチやその他異形基板にも検討可) |
|
ウェットエッチング |
各種金属膜エッチング |
酸/アルカリ系各種 |
最大Φ8″対応可能(2,4,6インチやその他異形基板にも検討可) |
|
SRD(スピン・リンス・ドライ) |
– |
– |
ウェハー加工・エッチング装置「RIE-10NR」
シリコン薄膜の高精度エッチングを目的とした平行平板型反応性イオンエッチング(RIE:Reactive Ion Etching)装置です。 プログラムコントロールによる自動稼働とプロセスパラメータの保存が可能な機能を持っています。
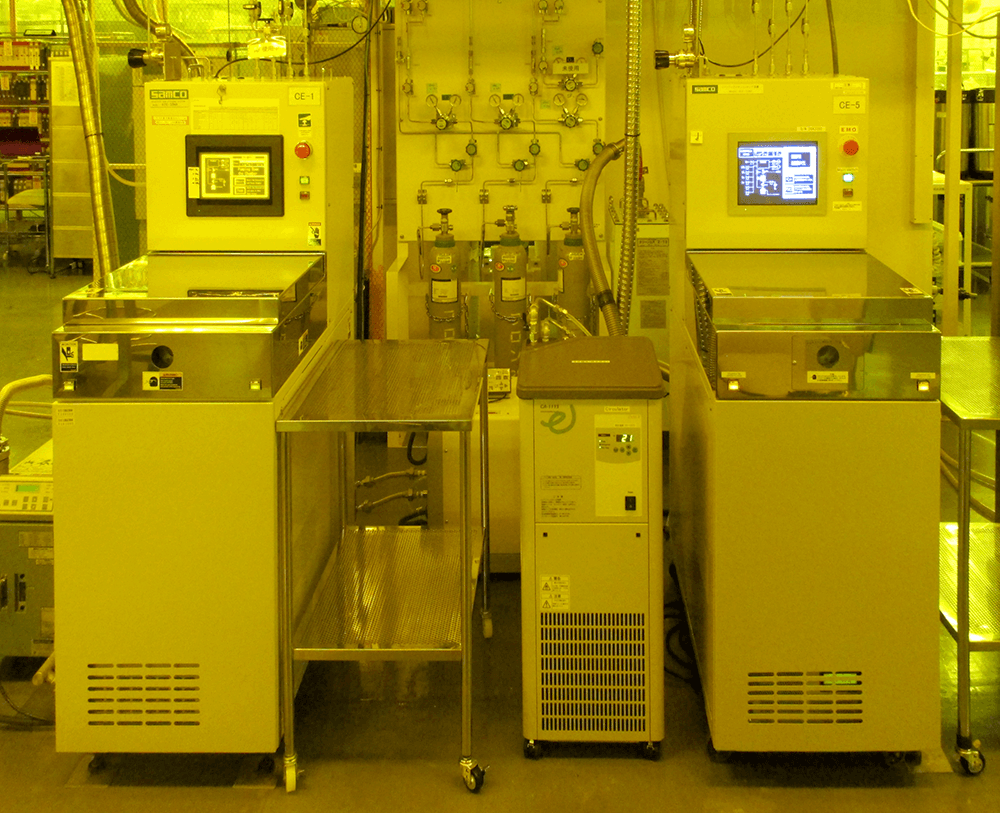
平行平板型RIE装置 RIE-10NR
|
スペック |
|
|
平行平板型RIE装置 RIE-10NR |
最大8インチサイズ対応(2,4,6インチやその他異形基板も検討可 。)Si、Poly-Si、SiO₂、SiNなどの各種シリコン薄膜の高精度エッチング。 |
エッチング
半導体の基板上もしくは、表面上の膜やレジストに目的の凹凸をつけて削っていく加工方法です。エッチングは基本的にパターニングされたレジストがマスクとして加工しますが、場合によってはSiO2をパターニングしてマスク用に使用する場合もあります。2種類のエッチング方式が用いられ、それぞれ溶媒を使う「ウエットエッチング」と溶媒を使わない「ドライエッチング」と呼ばれます。
ウエットエッチング
化学薬品による薬液を使用し、基盤を浸して無駄な部分を除去するエッチング方法です。ウエットエッチングでは等方性になりやすく、下方向にエッチングされて削られると同時に、横方向も同時進行で削られます(サイドエッチング)。
ドライエッチング
ガスに高周波をかけて、イオンやラジカルで対象物を加工する方法です。ガスにもよりますが、主に異方性の形状になりやすく、垂直方向にイオンがぶつかり、一定方向に削れて加工されます。RIEは反応性イオンエッチング(Reactive Ion etching)とも呼ばれ、プラズマ中に電位が生じてイオン等が試料に衝突して削ることを意味します。








